(独)産業技術総合研究所と大日本印刷(株)は1月28日、200mmの大口径ウエハー上に圧電薄膜であるチタン酸ジルコン酸鉛(PZT)薄膜を均一に形成できる装置を開発し、圧電MEMSデバイス(圧電材料を用いた微小電気機械システム)を200mmウエハー上に作製するプロセス技術も確立したと発表した。
■粗大粒子生成を抑え、歩留り向上
PZT薄膜を用いた圧電MEMSデバイスはインクジェットヘッド、ジャイロセンサーなどが100mm、150mmウエハープロセスで製造されている。しかし、PZT薄膜形成の難しさから200mmウエハープロセス化は進まず、生産性の向上や低コスト化の障壁となっていた。
研究チームは今回、200mmウエハーにPZT薄膜を形成できる自動ゾルゲル形成と呼ばれる装置を開発するとともに、歩留まり低下の原因となる粗大粒子の生成をウエハーあたりこれまでの300個以上から20個以下へと抑制できる薄膜形成条件を見出した。
さらに、PZT薄膜を形成したこの200mmウエハーを、圧電MEMSデバイスに微細加工するプロセス技術を大日本印刷と共同開発した。
得られたデバイスの性能を調べたところ、実用レベルの圧電定数をウエハー全面で確認できたという。今後は試作した圧電MEMSデバイスの量産化などに取り組みたいとしている。
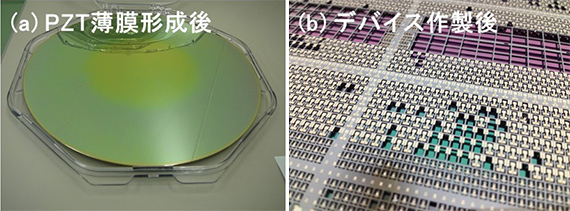
(a)は、PZT薄膜を形成した200mmウエハー。(b)は、200mmウエハーで作製した圧電MEMSデバイス(提供:産業技術総合研究所)



