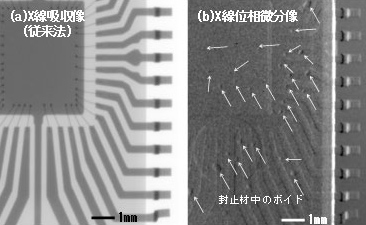
ICパッケージの撮影実験。(a)X線吸収像(従来のX線非破壊検査法)で、(b)X線位相微分像。封止材中のボイドは(a)では全く観察できないが、(b)では多数のボイドが明瞭に観察できる(提供:産業技術総合研究所)
(独)産業技術総合研究所と東北大学は10月2日、従来のX線非破壊検査法ではとらえることができなかった電子部品内部の欠陥を、「X線タルボ干渉法」と呼ばれる手法を用いると撮影が可能なことを実証したと発表した。実験室レベルの小型X線源でも撮影できるため生産現場で容易に利用でき、製品の品質管理の高度化、効率化に役立つという。
■内部の割れ目・空孔を発見
X線タルボ干渉法は、観察対象物と受像機の間に2枚のX線格子を挟み、最初の格子の後ろに現れるX線回折像と、2つ目の格子の重ね合せでできるモアレ模様から、通常のX線吸収像のほかに、X線位相微分像、X線散乱像も同時に取得する手法。
医療用としての研究開発が先行しているが、研究チームは工業応用の可能性に着目、今回、電子部品を対象に撮影を試みた。電子部品は金属のほかセラミックスや樹脂などX線吸収係数の異なる材料で構成されており、X線吸収像をとらえる従来のX線非破壊検査法では樹脂などX線吸収係数の小さい部材の欠陥把握は困難だった。
実験の結果、これまでは全く見えなかった封止材(半導体や金属配線を保護している樹脂部材)の内部のボイド(割れ目、空孔)や表面の傷、セラミックス絶縁体内部のクラックなどの観察に成功した。電子部品のこのような欠陥を実験室レベルのX線装置で撮影できたのは世界で初めてという。
産総研では、今後X線の高エネルギー化、それに対応できるX線格子の作製、コンピューター断層撮影のような立体画像の構築などの研究を進め、現場のニーズに応えていきたいとしている。



